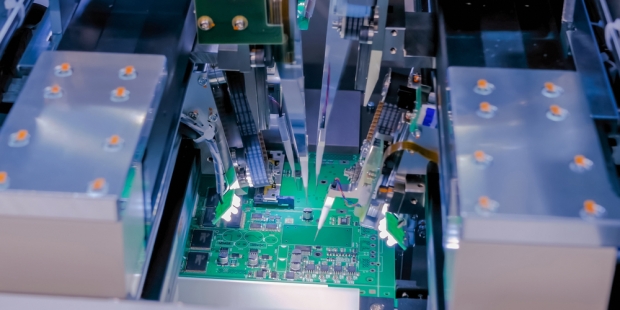
环旭电子微小化创新研发中心成功整合VPE与铜柱巨量移转技术
(全球TMT2025年12月10日讯)环旭电子微小化创新研发中心(MCC)宣布,历经三年研发与验证,成功整合真空印刷塑封(Vacuum Printing Encapsulation, VPE)技术与高径深比(>1:3)铜柱巨量移转技术,并率先导入胶囊内视镜微缩模块与高散热行动装置电源管理模块,展现跨领域系统级微型化封装的实质成果。同时,MCC亦完成多折高线弧打线(Multiple Bend, High Wire Loop Profile)与基板级选择性塑封(Board-level Selective Encapsulation)的整合技术,并成功应用于基站射频功率放大器模块的开发。

真空印刷塑封技术采用液态塑脂印刷,钢板开制仅需1周,不需任何客制模具,使产品从设计到量产的时程可缩短达90%;并能以更有成本优势、交期更短的FR4 PCB取代BT载板,协助微型化产品降低约30%的开发成本。FR4 PCB的室温封填与低模流压特性,尤其适用于模块设计采用对高温或高模流压敏感的组件,例如微机电、高径深比铜柱与高线弧打线等。




文章评论(0)