华为突破制裁的新方向,苹果抢先量产!“芯片堆叠”真能成为后摩尔时代行业的出路?
(全球TMT2022年6月2日讯)芯片堆叠的“苹果方式”和“华为方式”
在今年3月份的苹果春季发布会上,一款被称为“最强芯片”的M1 Ultra横空出世,让很多消费者惊讶于苹果 “双芯合一”的新打法。根据苹果的介绍,这款M1 Ultra芯片并非全新设计,而是将两枚M1 Max中隐藏的芯片间互连模块(die-to-die connector) 通过苹果自研的“Ultra Fusion”架构整合在一起,成为一个新的芯片。简单来说,M1 Ultra就是直接由两颗M1 Max内部互连而成,所以M1 Ultra拥有20核CPU、64核GPU,其各项规格均是M1 Max芯片的两倍。当然性能加倍的同时面积也翻倍。
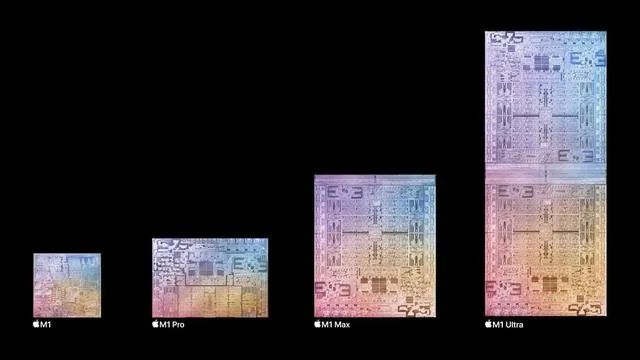
当时,苹果M1 Ultra的制造方式就让很多人想起了“传闻”中华为海思的一项“芯片叠加技术”。即一颗主芯片由芯片1和芯片2组成,芯片1和芯片2之间持续同步信号传输,再将芯片传输到主芯片。

3月底,时任华为轮值董事长的郭 平在2021年业绩说明会上表示,“华为未来将投资三个重构,用堆叠、面积换性能,用不那么先进的工艺也可以让华为的产品有竞争力。”也就是说,华为可以通过增大面积,堆叠的方式来换取更高的性能,实现低工艺制程追赶高性能芯片的竞争力。此次表态证明,华为在芯片领域已经有了明确的目标和打法。
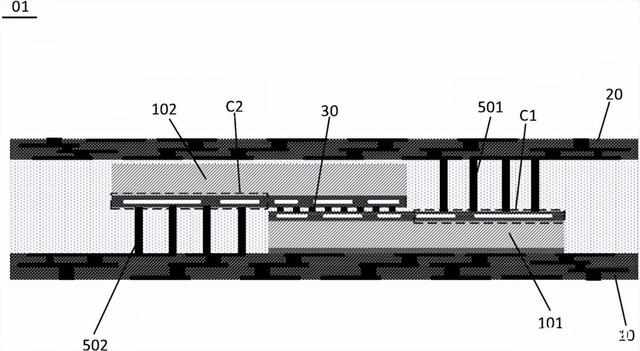
4月初,华为公布了一个关于芯片封装部分的技术专利。该项专利申请提供了一种电子设备、芯片封装结构及其制作方法,该芯片封装结构包括:基板、至少一个桥接板以及至少两个第一芯片。5月,华为又公开了一项名为“芯片堆叠封装结构及其封装方法、电子设备”的专利,该专利用于解决如何将多个副芯片堆叠单元可靠的键合在同一主芯片堆叠单元上的问题。至此,华为的“芯片叠加技术”算是正式现身了。这项专利提交申请的时间是2019年,也证明了华为确实在芯片受到制裁的同时没闲着,找到了一种解决“无芯可用”的新方法。
不过值得一提的是,与上面提到的苹果M1 Ultra芯片直接水平拼接的方式不同,华为采用上下堆叠的方式,同时将两枚芯片各保留一端的接口与外界连接。这样就使得华为的堆叠芯片比单个芯片更厚,但面积不至于是单个芯片的两倍。
为什么要采用芯片堆叠?
其实芯片堆叠并不是一个新鲜的词。
在整个半导体行业戈登摩尔提出的摩尔定律几乎被认为是“金科玉律”,引领了近50多年来半导体技术的发展。但近些年,越来越多的行业人士开始担心摩尔定律将走向终结。突破摩尔定律或给摩尔定律续命成为很多芯片行业尖端人才关注的问题。
其中SiP(System-in-Package) 系统级封装技术是被认为是一种超越摩尔定律的路线。资料显示,SiP采用对不同芯片进行并排或叠加的封装方式,将多个具有不同功能的有源电子元件与可选无源器件,以及诸如MEMS或者光学器件等其他器件优先组装到一起,实现一定功能的单个标准封装件。这种方式具有开发周期短、功能更多等优点。
苹果M1 Ultra则是利用这种堆叠方式将两个一样的芯片通过技术连接进行封装,从而达到性能的翻倍。在目前芯片工艺水平发展接近极限的情况下,堆叠设计的方式不失为一种好的选择。
另外若从华为自身角度来看,在高端芯片受到制裁的情况下,通过芯片堆叠或许可以酝酿出高端芯片。就像华为自己说的,“甚至可以让14nm芯片经过优化后比肩7nm性能。” 此外,在芯片堆叠方面先进的光刻机设备并不是必要,华为也不会受到技术卡脖子的遭遇。
那么芯片堆叠的效果怎么样?
其实苹果M1 Ultra芯片的问世已经证明了“芯片堆叠”技术的可行性,不过这颗芯片的效果却也让人产生质疑。PassMark天梯榜数据显示,M1 Ultra典型功耗高达60W,烤机功耗最高达到180W。所以华为堆叠芯片虽然还未正式生产,目前来看仍面临两个问题,即手机内的空间设计和厚度增加功耗增加所带来的散热问题。
根据此前爆料,华为芯片堆叠专利公开可能意味着华为已经完成了基础测试和实验测试,堆叠芯片成品会在18个月内与消费者见面,效果如何还是要用产品说话。
芯片堆叠是后摩尔时代的未来?
可以预见“芯片堆叠”技术确实是有在芯片制造领域成为趋势的可能性,毕竟苹果、华为两大巨头均已有所探究。
今年3月初,英特尔、AMD、ARM、Google Cloud、Meta、微软、高通、三星、台积电等联合宣布成立行业联盟,以建立小芯片生态系统,制定小芯片互联标准规范“UCIe”。小芯片的原理其实是将多张低制程,小规格芯片组合使用,从而实现到高制程芯片的转变。这个过程也是在践行芯片堆叠的理念。在中国也有计算机互连技术联盟CCITA,该联盟立项了Chiplet 标准,即《小芯片接口总线技术要求》。
芯片堆叠或许是后摩尔时代芯片行业发展的一个可选方向,但是不是最优解还需要在实践中检验。




文章评论(0)